苏州纳米所研究揭示场板抑制GaN基HEMT电流崩塌机理
基于宽禁带半导体GaN的AlGaN/GaN HEMT是下一代大功率电力电子器件的发展方向。然而在高压开关工作下的AlGaN/GaN HEMT器件的电流崩塌现象严重影响着其性能,场板结构是缓解器件电流崩塌的常用手段。国际学术界对场板抑制电流崩塌的机理认识归结为:场板能够减弱漏侧栅极边缘电场集中,减少了栅极向势垒层中电子电荷的注入。
中科院苏州纳米所纳米加工平台对高压大功率AlGaN/GaN HEMT器件开展了系统的研究,在国际上首次提出并制备了新颖的双栅HEMT器件,这一器件结构不仅能有效改善器件的动态特性,而且还能够帮助人们深入理解场板抑制电流崩塌的机理。研究成果发表在IEEE Electron Device Letters( vol.34, p.217, 2013)。在国际半导体产业界和学术界具有广泛影响的知名杂志Semiconductor Today对此研究结果进行了报道。(原文链接)
新颖的双栅AlGaN/GaN HEMT器件除主栅之外新加了一个可以单独加信号控制的顶栅,顶栅通过介质层与主栅隔离,覆盖在主栅上方,并且向源端和漏端各有一定长度的延伸(见图1)。
这一双栅AlGaN/GaN HEMT器件能够模拟普通的源场板器件和栅场板器件,即:在动态工作期间,通过对顶栅上加恒定0V电位,使双栅器件等效成源场板器件;在对顶栅施加与主栅相同的电位时,使双栅器件等效成栅场板器件。脉冲开关实验发现(见图2):普通结构HEMT的开启时间为2.75μs,开态电阻为2916Ω。而源场板和栅场板都使器件的动态特性得到了明显的提高,开启时间和开态电阻分别为:1.6μs和1.05μs,500Ω和470Ω。根据通常解释:电流崩塌主要是由于器件处于关态时,栅电极边缘靠近漏电极一侧会有很大的电场集中,所以在此区域会有大量的电荷被缺陷捕获。场板可以使此处的电场降低,减少此区域被捕获的电荷量,从而使器件的动态性能得到有效的提高。可是为什么栅场板器件的动态特性优于源场板器件?
由于双栅AlGaN/GaN HEMT器件的顶栅可以独立控制,所以器件动态工作时,通过对顶栅在关态下加不同电位,能够对器件的电流崩塌做更深入的研究分析。实验发现,随着顶栅关态下负电位的加大,器件的动态特性变好(见表1)。通过分析,提出了新的解释(见图3):在关态下,具有场板结构的HEMT器件栅边缘电场不仅强度降低,而且当顶栅上加负电压时,栅边缘的横向电场强度与纵向电场强度的比例会降低,意味着电子的捕获区域范围会减小;再者,栅场板器件在开启状态下,顶栅是处于正压(+1V),能够在沟道中感生出额外的电子;这两个因素决定了栅场板器件抑制电流崩塌效果优于源场板。
双栅AlGaN/GaN HEMT器件不但帮助人们深入认识理解器件的物理机制,而且提供了新的双栅驱动模式,即:主栅脉冲信号在开关状态间切换,顶栅在关断时与主栅电位一致,而在开启时施加更高的正向电位。实验表明:相比于加+1V,顶栅电压在开态时施加+20V,器件的开启时间减小到0.78μs,开态电阻降低到430Ω。
双栅AlGaN/GaN HEMT器件是一种新颖的器件,目前初步的研究结果显示,它不仅能加深人们对器件的认识,而且还能为提高器件的动态性能提供新的解决途径,其潜在的价值还没有完全显现,还需要对这种新器件进行更加深入系统的研究。
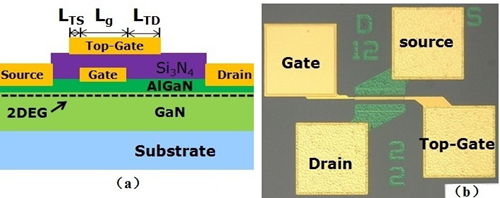
图 1、(a)双栅 HEMT 的剖视图,(b)双栅 HEMT 的显微镜照片
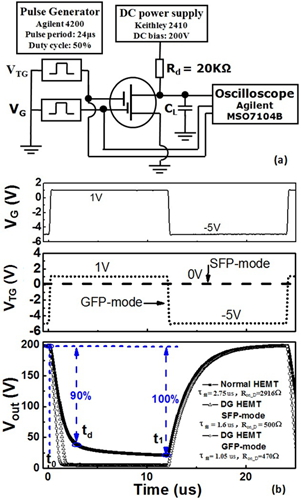
图2、(a)动态测试系统简图;(b)双栅器件输入信号和输出信号波形图
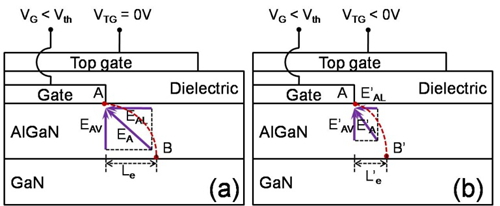
图3、(a)关态下,顶栅加0V,栅电极边缘的电场强度;(b)关态下,顶栅加负电压,栅电极边缘的电场强度。
|
VTG-off-state(V) |
τfd(μs) |
Ron_D(Ω) |
|
-5 |
1.25 |
480 |
|
-10 |
0.93 |
440 |
|
-15 |
0.8 |
420 |
表1、开启时间(τfd )和动态电阻( Ron_D)与关态顶栅电位
附件下载:
